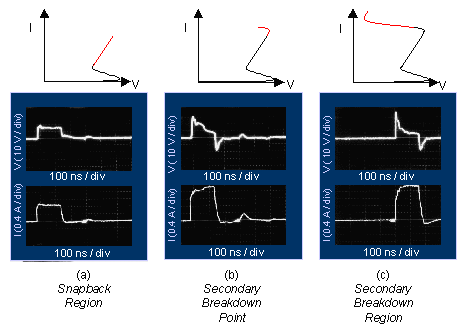
圖5.3-1
須先處理,首先必需先將待測元件以HP 4145之類的儀器
量測出元件的第一崩潰點電壓,以做為起始充電電壓的參
考值。
開始量測元件時,改變充電電壓為變數,逐步增加充電電
壓,而在示波器上觀測元件上的電壓/電流值。元件在各
偏壓區域下的觸波電壓/電流波形量測於圖5.3-1中。圖5.3-
1(a)的波形,是元件在驟迴崩潰(Snapback Breakdown)區的
特性。到二次崩潰點時,會有電流突升而電壓突降的波形
產生,如圖5.3-1(b)所示。最後充電電壓再增大時,電流會
再度增大而電壓會下降更多,此時元件已進入二次崩潰的
狀態,如圖5.3-1(c)所示。
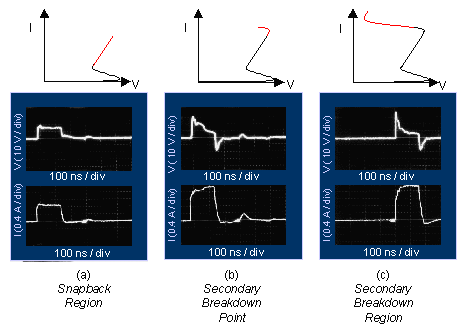
利用一點一點的觀測可描繪出元件在崩潰區的電壓/電流
特性曲線,如圖5.3-2所示。
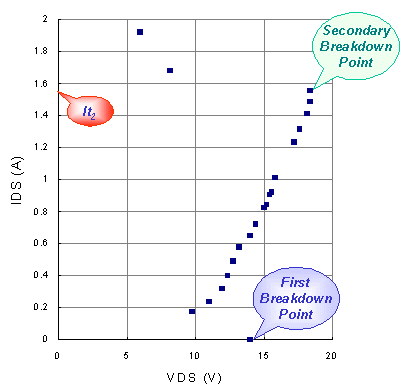
然而在量測時尚有一情況需考慮,若一開始就發現量測時
的觸波波形為階梯狀時,表示待測元件的內阻值已大於傳
輸線特性阻抗,此時在量測儀器上必需做一些改變,以因
應量測系統的準確性。由所提供的充電電壓及量測到的觸
波電壓,利用方程式(4),可大約計算出元件的內阻值。可
並聯一相當的電阻,使並聯後的總電阻小於傳輸線特性阻
抗,但並聯點必需在電流量測點之外,且在電壓量測點之
內,如此即可做一校正性的量測。
 , (4)
, (4) 點時,即停止更高充電電壓的量測,只要觸波脈寬(觸波能
量)不是很大(得視元件本身的特性而定),在二次崩潰點偏
壓下元件依然不致損壞。然而一旦進入了二次崩潰區後,
元件可能因過大的能量衝擊而損傷,由此可知只要小心量
測,元件在量測後是不致於損毀的。而在考慮脈寬的因素
下,當使用較寬的觸波(L1較長)時,
在量測二次崩潰點是比較容易判斷,然而其缺點是容易造
元件的隕壞,而且超過150奈秒的觸波,已不是正確之靜電
放電的波形。但若使用太小脈寬的觸波時,所需提供的電
壓要更高,量測所需花費的時間要更長,因此如何選用適
當的脈寬,除了需搭配元件的特性外,更需要實際經驗的
累積。
此套TLPG系統,可藉由電腦及其它Switch Box的輔助而架
設成自動測量的系統。一套自動量測的TLPG系統示意圖
顯示於圖5.3-3中。
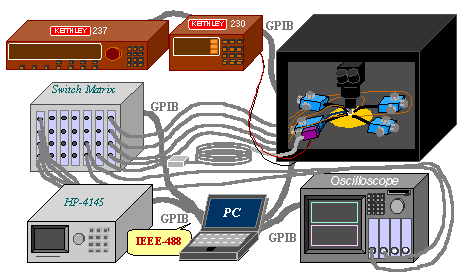
由以上的實際測量中,可看出此量測系統的作用,不外乎
是利用可控制的有限能量以量測元件的電壓/電流特性曲線
,然而這個可以量測元件二次崩潰現象的量測系統,這並
不是市面上的一些量測儀器所能做到的。此TLPG系統亦可
用來做其它方面的測量應用,例如可以用來量測閘極氧化
層(Gate-Oxide)的脈衝崩潰電壓,甚至測量深次微米製程下
閘極氧化層所能承受的最大ESD電壓。