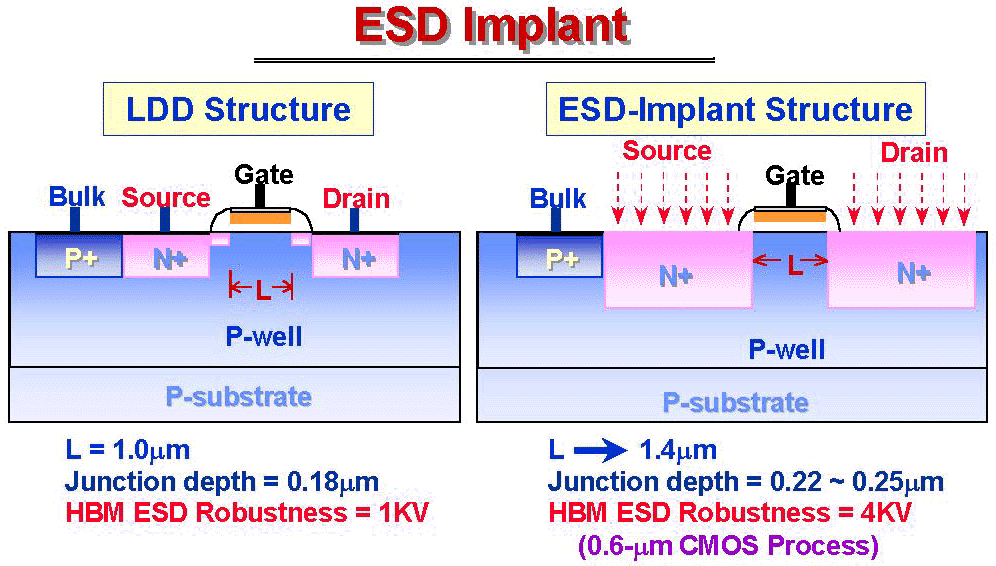
圖6.2-1
目前發展出兩種製程技術以應用於量產製程中。
左半邊的是次微米製程下的標準元件結構,擁有LDD的汲
極(Drain)及源極(Source),此LDD是用來減低MOS之汲極端
在通道(channel)下的電場強度分佈,以克服因熱載子效應(
Hot carrier effect)所造成的I-V特性因使長時間用而漂移的問
題。但這個LDD結構做在MOS元件通道(channel)的兩端,
LDD的深度(junction depth)只有約0.02μm,這等效在汲極與
源極的兩端形成了兩個"尖端",ESD放電作用類似於雷擊,
"尖端放電"的現象便容易發生在LDD這個尖端結構上,當這
種LDD元件用於輸出級(output buffer),NMOS元件很容易便
被ESD所破壞,即使NMOS元件在輸出設計中擁有很大的尺
寸(W/L),其ESD防護能力在HBM測試下仍常低於1000伏特
。
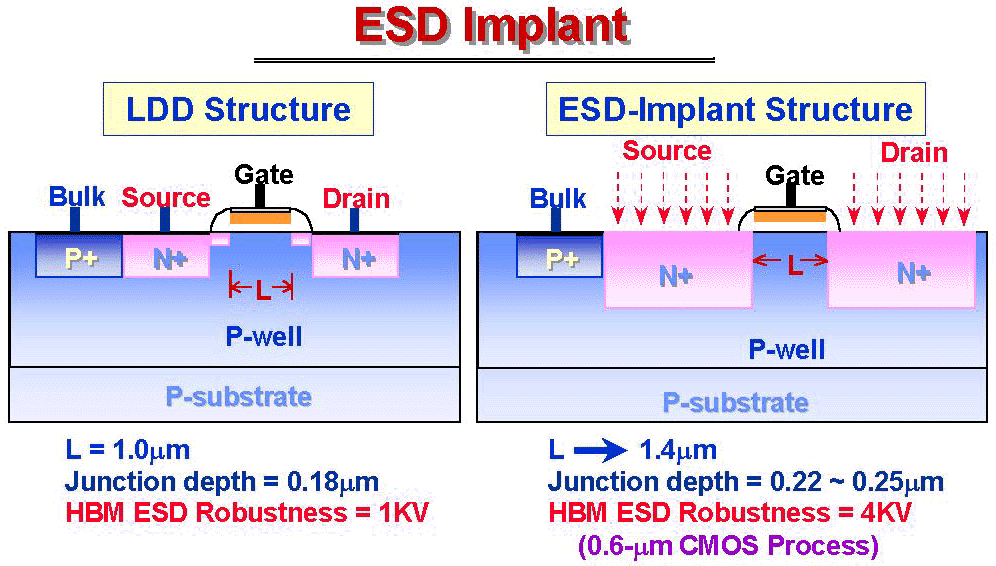
,製程上便發展出ESD-Implant Process,其概念乃是在同一
CMOS製程中,做出兩種不同的NMOS元件,一種是給內
部電路用,具有LDD結構的NMOS元件,另一種是給I/O(
輸入/輸出)用,但不具有LDD結構的NMOS元件。要把這兩
種元件結構合併在同一製程中,便需要在原先的製程中再
加入一層ESD-Implant用的Mask(光罩),利用此ESD-Implant
Mask再加上一些額外的製程處理步驟,便可在同一製程中
做出不同的NMOS元件。由於用ESD-Implant Mask做出的元
件不具有LDD的結構,其結構像傳統long-channel的製程所
做出的元件,故其像早期的NMOS元件一樣,能擁有較高
的ESD防護能力。利用ESD-Implant Process做出來的NMOS
元件擁有較深的接面深度(Junction Depth),故其會有較嚴
重的橫向擴散作用,這導致利用ESD-Implant Process做的
NMOS元件不能用太短的channel length(L)。例如,在一
0.6μm的CMOS製程下,ESD-Implant Process的NMOS元件
最小通道長度L是1.4μm。
另外,用ESD-Implant Process做的NMOS元件與LDD結
構的NMOS元件不同,故需要額外的處理及設計來抽取這
種ESD-Implant NMOS元件的SPICE參數,以利電路模擬與
設計工作的進行。雖然ESD-Implant的NMOS元件會增加製
程處理上的步驟,增加通道長度L,增加元件參數抽取上
的處理,但這些成本上的增加卻可換來CMOS IC在ESD防
護能力上的有效提昇。例如圖6.2-1所示,在相同channel
width (W=300μm)情形下,LDD結構的NMOS元件,其ESD
防護能力只有約1000V(HBM);但ESD-Implant的NMOS元
件,其ESD防護能力可提昇到4000V。
此外,有另一種ESD-Implant的做法,如圖6.2-2所示,
把一濃摻雜濃度硼(P型)打入在contact正下方N型diffusion與
P-substrate接觸面之間,以降低該接面的崩潰電壓,例如
在一0.35微米的製程中,可把原先約~8V的接面崩潰電壓
降低到約 ~6V。因為該接面具有較低的崩潰電壓,當靜電
放電出現在該NMOS元件的汲極(drain)時,靜電放電電流
便會先由該低崩潰電壓的接面放電,因此該NMOS元件汲
極端的LDD結構不會因靜電尖端放電的現象而先被靜電損
傷。利用這種做法,NMOS元件仍可保有LDD結構,因此
該NMOS元件仍可使用較短通道的channel length,而且該
NMOS元件的SPICE參數跟其他的NMOS元件相同,除了
接面崩潰電壓之外,不必另外抽取這種ESD-Implant的
NMOS元件的SPICE參數。
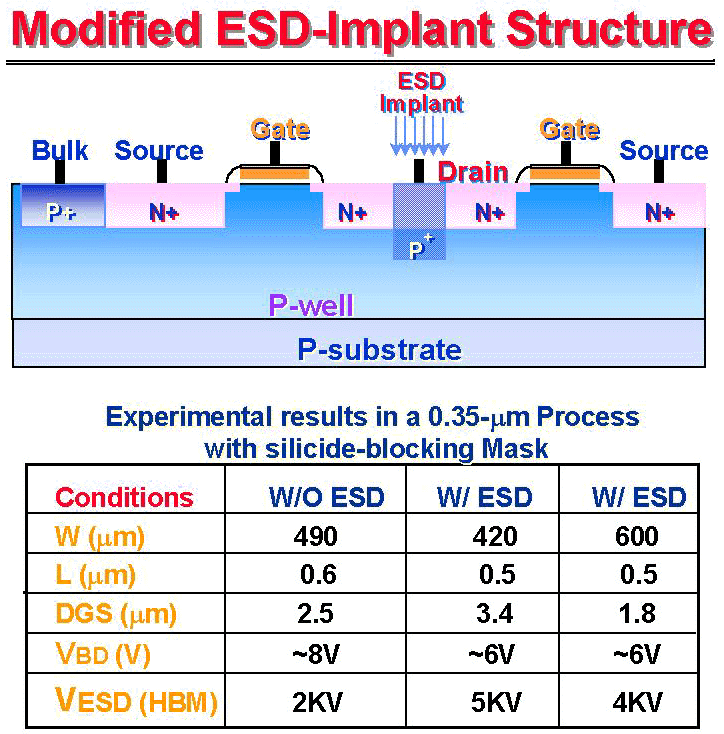
源極端的串聯雜散電阻Rd及Rs,在一沒有silicided diffusion
的CMOS製程下,N+ diffusion的阻值約30~40Ω/□,但在有
silicded diffusion的先進製程下,其阻值下降到約1~3Ω/□,
由於擴散層的Sheet Resistance大幅降低,使得MOS元件的操
作速度可以有效地提昇,因而使CMOS技術可以做到更高頻
率的應用。silicided diffusion技術在0.35μm(含)以下的CMOS
製程中已屬於標準配備。
但當有silicided diffusion的MOS元件被用來做輸出級的
元件時,由於其Rd與Rs都很小,ESD電流很容易便經由
PAD傳導到MOS元件的LDD結構,一下子就因LDD做"尖端
放電"而把MOS元件破壞掉,因此在0.35μm製程的MOS元
件,其ESD防護能力更大幅度地下滑,畫製再大尺寸(W/L)
的元件當輸出級也無法有效地提昇其ESD防護能力。為了
提昇輸出級的ESD防護能力,在製程上發展出Silicided-
Diffusion Blocking的製程技術,其概念乃把輸出級用的
NMOS元件中的silicided diffusion去除,使其汲極與源極的
sheet Resistance回復到30~40Ω/□的阻值,因而使MOS元件
具有較高的Rd與Rs,較大的Rd與Rs可以有效地提昇MOS元
件對ESD的防護能力。為了達成上述目的,在製程上需要
多用一層光罩來定義出silicided diffusion blocking的區域,
如圖6.2-3所示。實驗數據顯示,channel width W=300μm
的NMOS元件在silicided diffusion製程下(含LDD結構),其
HBM的ESD耐壓度低於1000V,但若使用silicided-diffusion
blocking的技術,在相同channel width下(含LDD結構),其
ESD耐壓度可提昇到約4000V,這顯示了Silicided-diffusion
Blocking Process用在I/O元件上對ESD防護能力的提昇作用
。雖然Silicided-diffusion Blocking技術對ESD防護能力有所
提昇,但除了增加製程複雜度之外,亦會因Silicided-
diffusion的Blocking處理過程而容易造成污染的問題,這會
造成低良率(low yield)的問題,因此在製程處理上需要更精
細的技術控制。
.gif)
|
.gif)
|
.gif)
|
.gif)
|
ESD-Implant技術去掉LDD結構,再用Silicided-diffusion
Blocking技術去除輸出級MOS元件的Silicided diffusion,這
樣更可以大幅提昇CMOS IC輸出級的ESD防護能力,但其
相對地在製程處理上的步驟及製造成本也會增加。
除了利用Silicided-diffusion Blocking技術來去除輸出級
NMOS的silicided diffusion之外,另有一種高明的技巧可達
到相同的功效而不需要用到Silicided-diffusion Blocking的製
程處理。圖6.2-4顯示了這種利用N-well來達到Silicided-
diffusion Blocking的作用。在圖6.2-4中,其汲極(Drain)的N
+ diffusion是斷開的,位於中央中間的N+ diffusion利用
contact連接出去當汲極端,而斷開的區域(Field-oxide區域)
利用N-well結構把這中間的N+ diffusion連接到MOS通道的
汲極N+diffusion去。這N-well的作用等效是個電阻作用,
用來限制ESD放電的瞬間峰值電流;另外在contact下方包
有N-well結構,更可防止因ESD電流造成contact spiking而使
汲極與P-substrate短路的現象。利用這種N-well電阻的作法
,只要在佈局(Layout)時把汲極的N+ diffusion斷開,再畫上
N-well做適當的連接即可達成,不需要用到Silicided-diffusion
Blocking的額外光罩及製程處理程序。利用佈局上控制Field
-Oxide區域的spacing,即可做出不同大小的N-well電阻。這
N-well電阻會影到輸出級的推動能力,但只要稍微加大輸出
級的元件尺寸(W/L)即可適度地回復其正常的推動能力,而
達到實用且省錢的最佳效果。