.gif)
圖6.4-1(a)
.gif)
圖6.4-1(b)
護能力,其主要是利用ESD放電的瞬間電壓快速變化的特
性,藉由電容耦合(coupling)作用來使ESD防護電路或元件
達到更有效率的防護動作。
降,為提昇CMOS IC的ESD防護能力,在輸入/輸出PAD的
ESD防護用元件或輸出級電晶體元件都會被做得較大,以
期利用大尺寸的元件設計來提昇ESD防護能力。大尺寸的
元件在佈局上經常畫成手指狀(finger-type),例如一個
NMOS元件其W/L=1000/0.6,則會在佈局上畫成10支finger
,彼此互相並聯在一起。但是,在ESD放電發生時,這10
支finger並不一定會同時導通(一般是因Breakdown而導通)
,常見到只有2-3支finger會先導通,這是因佈局上無法使
每finger的相對位置及拉線方向完全相同所致,這2~3支
finger一導通,ESD電流便集中流向這2~3支的finger,而其
他的finger仍是保持關閉的,所以其ESD防護能力等效於只
有2~3支finger(約300/0.6)的防護能力,而非10支finger的防
護能力。這也就是為何元件尺寸已經做得很大,但ESD防
護能力並未如預期般地上昇的主要原因。
為克服大尺寸電晶體在ESD放電情下,不均勻導通的
情況,圖6.4-1顯示了利用電容耦合作用來使大尺寸電晶體
的每一finger能均勻地導通的設計。圖6.4-1(a)的設計是美
國德州儀器(TI)公司在1992年所報導的設計,該設計利用
NMOS的雜散Cgd電容做耦合元件,那個field-oxide device
加強了耦合電容的效用,當有正的ESD電壓突然出現在
PAD上時,此瞬間的電壓變化會導致NMOS閘極電壓跟著
上升,由於電容耦合作用之故。因NMOS的閘極上有耦合
的正電壓,故大尺寸NMOS元件的finger會被一起導通而進
入驟回崩潰區(snapback region),由於大尺寸輸出元件
NMOS的每一finger能夠均勻導通,ESD放電能量便可均勻
分散到每一finger來承受,因此其ESD防護能力才能夠被有
效地提昇,真正發揮大尺寸電晶體元件應有的ESD防護水
準。
.gif)
.gif)
圖6.4-1(b)
ESD放電下能夠均勻導通來旁通ESD電流的一個有效方法。
圖6.4-1(b)是此電容耦合技術應用於輸入級ESD防護電
路上的一種安排,GCNMOS(Gate-Couple NMOS)是ESD電流
旁通用的元件,具有大的尺寸。因應用在輸入端,故其閘
極需經由一電阻Rg(~10KΩ)接地,以使該GCNMOS在
CMOS IC正當工作時是關閉的。另有一NMOS連接成電容
狀Cc,此NMOS乃被用來加強電容耦合作用,當有正的ESD
電壓在輸入PAD上發生時,一部份的正電壓會經由Cd與Cc
耦合到GCNMOS的閘極,此閘極電壓會經由Rg放電到地去
,Rg的大小會影響閘極電壓的維持(Holding)時間。
GCNMOS因而可以達到均勻導通的目的,以提昇其ESD防
護能力。
四種測試組合,所以ESD防護設計必需要考慮這四種測試
組合的ESD放電路徑,以免引起內部電路損傷的問題。圖
6.4-2顯示了互補式閘極耦合靜電放電防護電路,在此電路
中,除了閘極耦合的NMOS之外,另有一閘極耦合的PMOS
,其在四種放電測試組合下的工作原理請參見圖6.4-3。
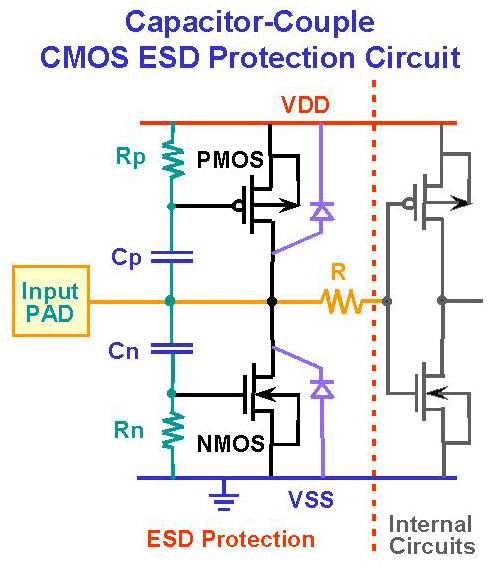
.gif)
.gif)
.gif)
.gif)
圖6.4-3
ESD電流,ND-mode ESD放電是利用閘極耦合PMOS元件來
旁通ESD電流,PS-mode ESD放電是利用閘極耦合NMOS元
件來旁通ESD電流。選擇合適的Cn(Cp)與Rn(Rp),此電路
能夠提供有效的ESD防護而不影響該CMOS IC的正常工作
。
圖6.4-4顯示此電路的實現技巧,該耦合電容可以利用
PAD與其下方Poly層的寄生電容來做,這可以不用佔用額
外的佈局面積來實現這個電路。其實際佈局方式請參見圖
6.4-5。


圖6.4-5
級及傳統的輸入級ESD防護電路,在低電壓製程下,PMOS
及NMOS的Gate Oxide越來越薄,例如,在0.25μm的CMOS
製程技術下,Gate-Oxide厚度只剩50A左右,如此薄的Gate
Oxide很容易便會被ESD所破壞。然而在傳統的輸入級ESD
防護電路設計上,常用一short channel的NMOS元件做第二
級保護,利用此NMOS的drain breakdown電壓來箝制gate-
oxide上的ESD電壓。但是隨著低電壓製程的演進,gate-
oxide breakdown電壓與drain breakdown電壓越來越接近,
甚至可能低於drain breakdown電壓,這時傳統的ESD防護
設計便無法有效地保護這種愈來愈薄的Gate Oxide。因此
一種結合前述LVTSCR元件與電容閘極耦合技術的靜電放
電電路設計便被發展出來。
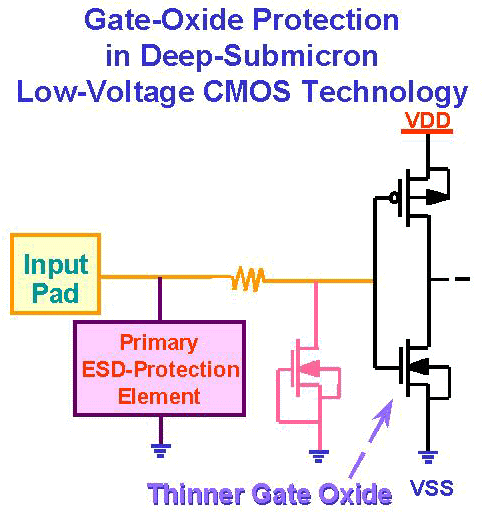
中,有一Gate-Coupled PTLSCR安排於PAD與VDD之間,有
一Gate-Coupled NTLSCR安排於PAD與VSS之間。在LVTSCR
元件介紹時已說明LVTSCR元件的導通電壓已下降到NMOS
(或PMOS)元件的drain breakdown電壓,但此drain breakdown
電壓在深次微米低電壓製程下,仍可能極接近(甚至大於)
Gate-Oxide breakdown電壓,為使LVTSCR元件的導通電壓
能夠再下降,利用Gate-Couple技術即可達成。當正的ESD
電壓發生在PAD上時,Cn會耦合正電壓到Mn1的閘極,因
此Mn1便會被導通,該被導通的Mn1會進一步觸發NTLSCR
元件的導通,當NTLSCR元件一被導通,其低的Holding
Voltage即可有效地箝制ESD電壓而得以保護輸入級內部的
薄閘極氧化層。相同地在ND-mode ESD放電情形下,
PTLSCR元件便會因Mp1的導通而觸發導通來保護內部的薄
閘極氧化層。因此,閘極耦合NTLSCR與PTLSCR元件的等
效導通電壓可以更被降低,且此導通電壓可藉由Cn (Cp)與
Mn1 (Mp1)的耦合作用來控制,也就是說可以做到可調性(
tunable)的設計。
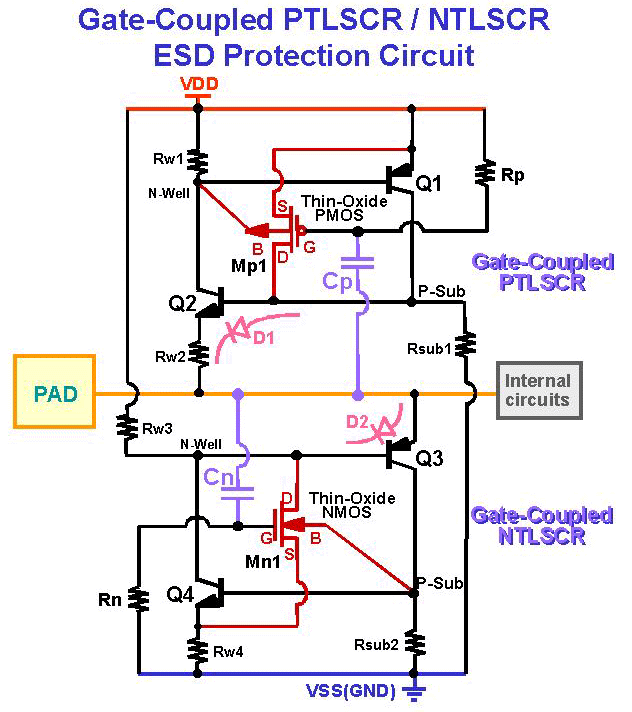
程處理,其ESD防護能力仍可藉由圖6.4-7的設計而大幅提
昇。當製程技術進步到深次微米的地步,前述的磊晶沈積
晶片將已大幅地被採用,且由於低電壓的工作需求,電路
的VDD電壓亦下降至僅約2.5V或1.8V而已,因此NTLSCR
與PTLSCR元件的Holding Voltage可以很容易地利用適當的
佈局間距而稍大於VDD電位,因此閘極耦合NTLSCR與
PTLSCR元件在深次微米低電壓的製程下,可是安全地用
來保護積體電路產品避免靜電放電的破壞。
圖6.4-8顯示圖6.4-7電路的元件剖面設計圖,該耦合電
容Cn與Cp可利用PAD與Poly的寄生電容來達成,在佈局上
改變這兩層重疊的面積即可調整耦合電容的大小,其實際
實施佈局圖參見圖6.4-9。
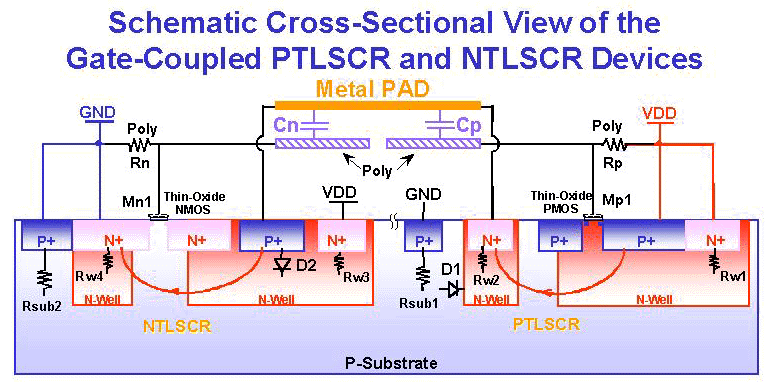
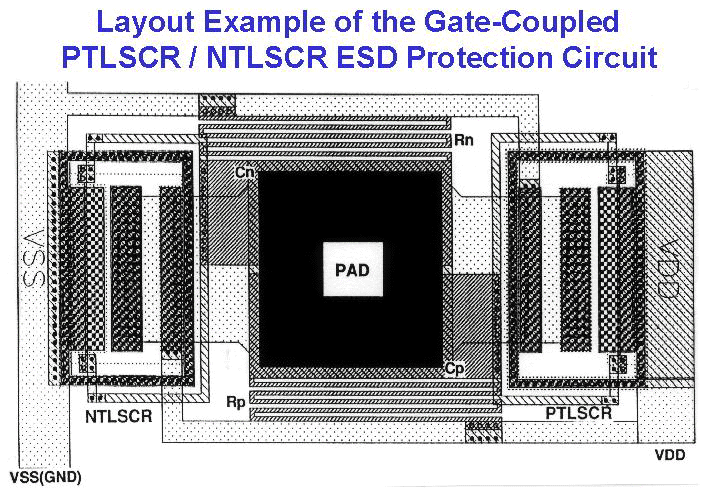
圖6.4-9
微米製程下,Poly層已大多用Ploycide,其具有更低的阻值
,在這種製程下,大阻值(~KΩ)的Rp與Rn若用Polycide的
Poly layer來拉,會佔用很大的佈局面積,此時可用小尺寸
的PMOS或NMOS來達成Rp與Rn的相同功能。這種適合用
在有Polycide或Salicide製程的閘極耦合互補式LVTSCR靜電
放電防護電路顯示於圖6.4-10中。
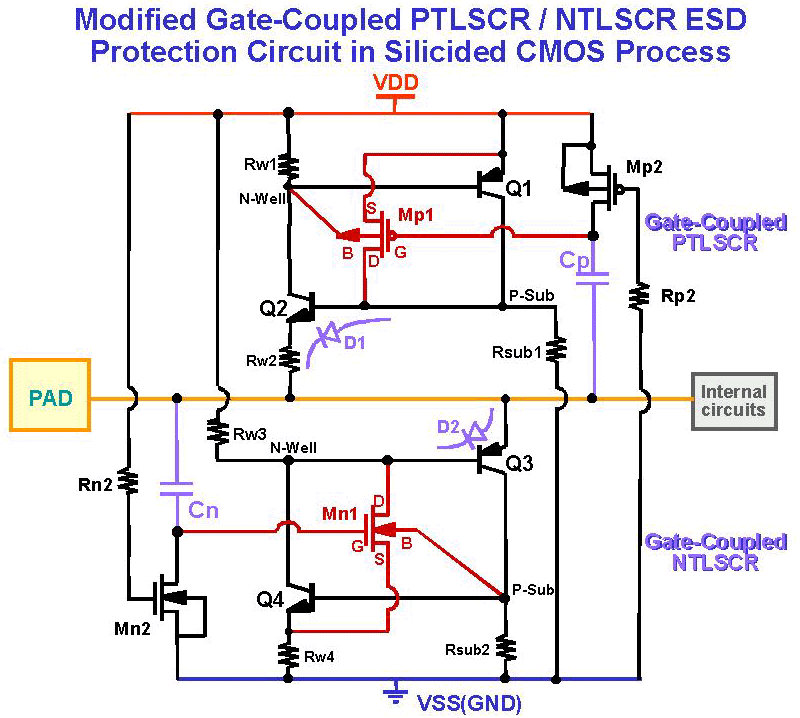
PMOS的元件特性測量圖參見圖6.4-11。關於Gate-coupled
NTSLSCR元件與傳統Gate-source短接的NMOS元件之元件
特性測量圖參見圖6.4-12。當PTLSCR/NTLSCR元件的閘極
具有負/正電壓時,其導通電壓(Switching Voltage)在圖6.4-
11與圖6.4-12中可被明顯地降低,故利用閘極耦合技術可
以有效地降低PTLSCR與NTLSCR元件的導通電壓,而得以
保護更薄的輸入級閘極氧化層。又LVTSCR元件能在最小
的佈局面積下提供最高的ESD防護能力,故此閘極耦合互
補式LVTSCR靜電放電防護電路集數項優點於一身。此電
路的實際ESD測試結果列於表6.4-1,此電路能夠在小的佈
局面積下提供有效且高水準的ESD防護能力,對講求輕薄
短小的IC產品而言,是一大技術性上的進步。
.gif)
.gif)
.gif)
.gif)
圖6.4-12
| Conventional CMOS ESD Protection Circuit with Large Dimension (W/L) | Gate-Coupled PTLSCR/NTLSCR ESD Protection Circuit | |||||||
| PMOS (500/1.2) | NMOS (500/1.2) | Gate-Couple PTLSCR | Gate-Couple NTLSCR | |||||
| Layout Area (μmxμm) | 158x92 | 166x100 | 110.2x68.3 | 107.0x65.2 | ||||
| ESD-Stress condition | PD-Mode | ND-Mode | PS-Mode | NS-Mode | PD-Mode | ND-Mode | PS-Mode | NS-Mode |
| HBM ESD Failure Voltage (V) | Above 8000 | -3000 | 1200 | Above -8000 | Above 8000 | -5775 | Above 8000 | Above -8000 |
| MM ESD Failure Voltage (V) | 450 | -350 | 150 | -850 | 750 | -500 | 600 | -700 |